新闻Position
你的位置:开云半岛·(中国)有限公司官网 > 新闻 > kaiyun网址这对大型集群来说是一个胜仗-开云半岛·(中国)有限公司官网
发布日期:2026-03-18 15:29 点击次数:64

据Tomshardware引述TF International Securities 分析师Ming-Chi Kuo的报说念kaiyun网址,因为市集对Nvidia(NVDA.US)顶端Blackwell双芯片设想的需求正在越过Nvidia的低端单芯片设想是以这家市值万亿好意思元的GPU制造巨头依然更新了其Blackwell架构路子图,优先接头承袭CoWoS-L封装的双芯片设想。
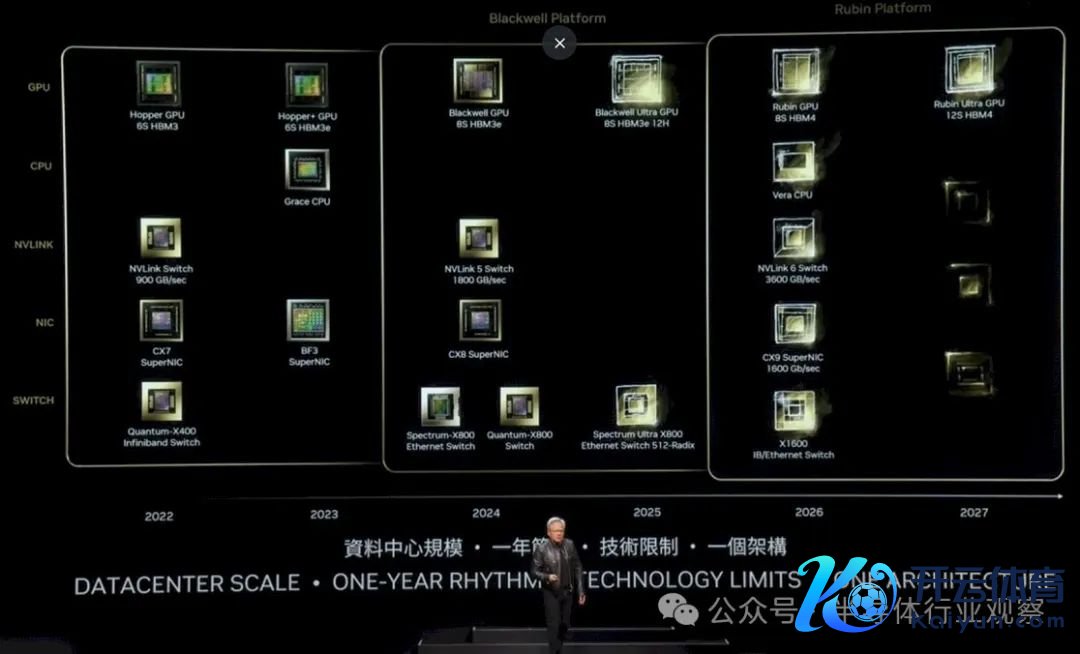 图注:英伟达此前公布的路子图
图注:英伟达此前公布的路子图
报说念进一步指出,从本年第一季度开动,Nvidia将专注于其 200 系列 Blackwell GPU。但值得注释的是,这仅包括 200 系列的多芯片版块,举例 GB200 NVL72 — 200 系列的单芯片版块,举例 B200A,依然停产。
相似,Nvidia 彰着目标优先接头哄骗多芯片的B300系列型号,尤其是 GB300 NVL72。由于对多芯片变体的需求较高,仅使用单个芯片的 B300 GPU 变体在制造中将处于低优先级。Nvidia 的高优先级 Blackwell GPU 型号使用台积电(TSM.US)更先进的 CoWoS-L 手艺。已停产的 B200A 和单芯片 B300 GPU 齐使用 CoWoS-S。
Ming-Chi Kuo暗意,由于这些变化,某些供应商将受到“尽头严重的打击”。
英伟达路子图,变了哪些?
按照此前的先容,英伟达有承袭双芯片设想200 系列,该系列包括 GB200 NVL72 和 HGX B200 等系统产物,使用 CoWoS-L 制造。
Nvidia 暗意,新款 B200 GPU 领有 2080 亿个晶体管,可提供高达 20 petaflops的 FP4 马力。此外,它暗意,将两个 GPU 与单个 Grace CPU 相诱惑的 GB200 不错为 LLM 推理责任负载提供30倍的性能,同期还可能权臣提高成果。据泄漏,与 H100 比拟,它“将资本和能耗缩短了25倍。
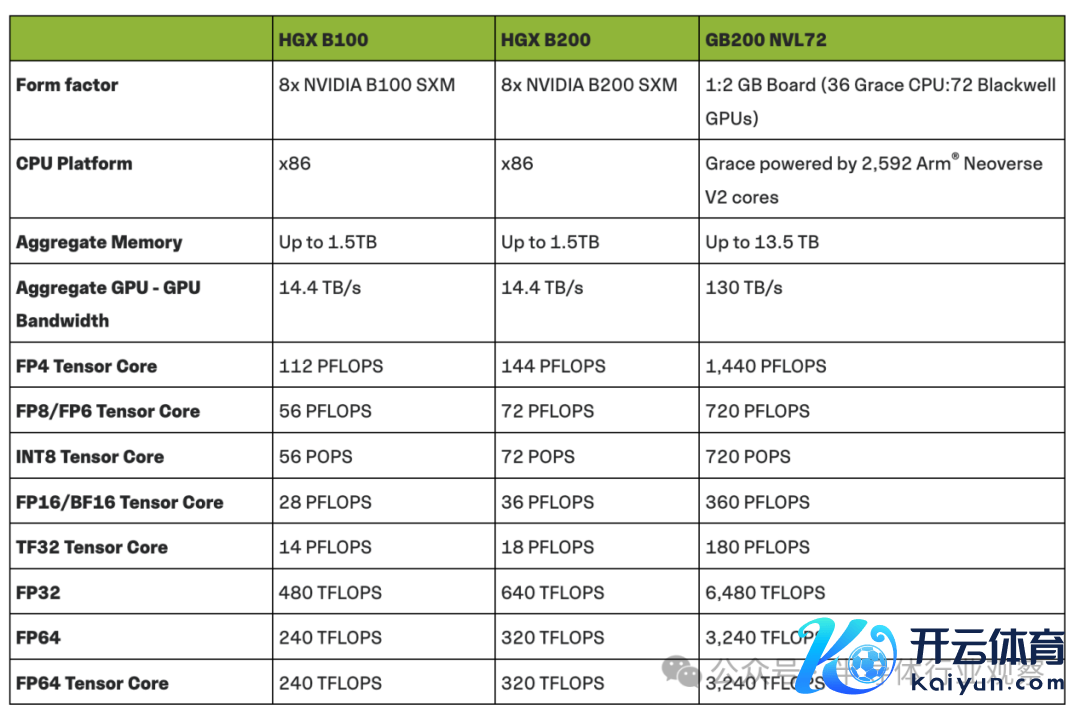
但Ming-Chi Kuo指出,200 系列不包括此前使用CoWoS-S工艺的单芯片版块B200A,因此它们不需要 CoWoS-S。
分析机构SemiAnalysis此曾暗意,Nvidia 目标推出一款名为 B200A 的新式 Blackwell GPU,它将是已推迟发布的 B200 GPU 的低端替代品。他们在一份论述中暗意,B200A 将包含高达 144GB 的 HBM3E 内存,并枉然高达 1000 瓦的功率,能无礼对低端和中端 AI 系统的需求。按照当先策动,B200A GPU 将用于 MGX GB200A NVL36 等业绩器,该业绩器最多因循 36 个 GPU。这可能会诱骗那些但愿构建较小 AI 模子的超大范围客户。
值得一提的是,B200A 将基于名为 B102 的die,“该die也将用于中国版 Blackwell的B20”。
但当今,如Ming-Chi Kuo所说,英伟达的策略变了。他进一步指出,从 2025 年 1 季度开动,Nvidia 将重心转向 200 系列,同期减少 H 系列的供应。这将进一步减少他们对 CoWoS-S 的需求。
在Ming-Chi Kuo的分析论述中,还对英伟达改日的B300进行了分析。他暗意,该系列底本策动了双芯片(CoWoS-L)和单芯片(CoWoS-S)设想,包括 GB300 NVL72(双芯片)和 HGX B300 NVL16(单芯片)等系统。
相似是SemiAnalysis的讯息骄气,Nvidia 的 B300 系列处理器承袭了经过大幅调治的设想,仍将承袭台积电的 4NP 制造工艺(针对 Nvidia 进行优化的 4nm 级节点,性能增强),但论述称,它们的策动性能将比 B200 系列处理器向上 50%。性能进步的代价是高达 1,400W 的 TDP,仅比 GB200 高 200W。SemiAnalysis 称,B300 将在 B200 上市大致半年后上市。
Nvidia B300 系列的第二项紧要矫恰是使用 12-Hi HBM3E 内存堆栈,可提供 288 GB 内存和 8 TB/s 带宽。增强的内存容量和更高的策动迷糊量将收尾更快的教授和推理,推理资本最多可缩短三倍,因为 B300 不错处理更大的批量大小并因循扩展的序列长度,同期处置用户交互中的延伸问题。
除了更高的策动性能和更大的内存外,Nvidia 的第二代 Blackwell 机器还可能承袭该公司的 800G ConnectX-8 NIC。该 NIC 的带宽是现时 400G ConnectX-7 的两倍,况兼有 48 个 PCIe 通说念,而其前代产物唯一 32 个。这将为新业绩器提供显然的横向扩展带宽矫正,这对大型集群来说是一个胜仗。
据先容,B300 和 GB300 的另一个紧要矫恰是,与 B200 和 GB200 比拟,Nvidia 据称将从头设想通盘这个词供应链。该公司将不再试图销售通盘这个词参考主板或通盘这个词业绩器机箱。相背,Nvidia 将只销售搭载 SXM Puck 模块、Grace CPU 和 Axiado 主机束缚限制器 (HMC) 的 B300。因此,将允许更多公司参与 Blackwell 供应链,这有望使基于 Blackwell 的机器更容易赢得。
借助 B300 和 GB300,Nvidia 将为其超大范围和 OEM 调解伙伴提供更多设想Blackwell 机器的目田,这将影响它们的订价以致性能。
不外,Ming-Chi Kuo指出,天然基于 B300 的系统目标于 2026 年大范围出货,但 Nvidia 和 CSP 咫尺更好奇使用CoWoS-L封装的GB300 NVL72 。天然也使用单芯片、CoWoS-S封装 B300 系统,但 GB300 NVL72 将优先接头。
因此,对 CoWoS-L 的需求比对 CoWoS-S 的需求更为进攻。
为此,Ming-Chi Kuo指出,产物路子图的这些振荡将在不同进度上影响 Nvidia 过火供应链调解伙伴的进展。某些供应商将受到尽头严重的打击,导致其股价近期出现大幅回调。不外,从 Nvidia 的角度来看,CoWoS-S 蔓延的放缓/减少主如果由产物路子图的变化而不是需求下滑所致。这一变化也与台积电将其 CoWoS-L 手艺实验为主流处置决议的计谋目标诟谇分明。
CoWoS-L和CoWoS-S,有何不同?
在上头的先容中,咱们看到了对于CoWoS-L和CoWoS-S的形色。这其实是英伟达CoWoS平台的两个版块。
据先容,CoWoS是Chip-on-wafer-on-substrate的简写。动作一种先进的封装手艺,CoWoS具有封装尺寸更大和 I/O 集结更多等上风。它允许 2.5D 和 3D 组件堆叠,以收尾同质和异构集成。以前的系统濒临内存死心,而现代数据中心则使用高带宽内存 (HBM) 来增强内存容量和带宽。CoWoS 手艺允许在并吞 IC 平台上异构集成逻辑 SoC 和 HBM。
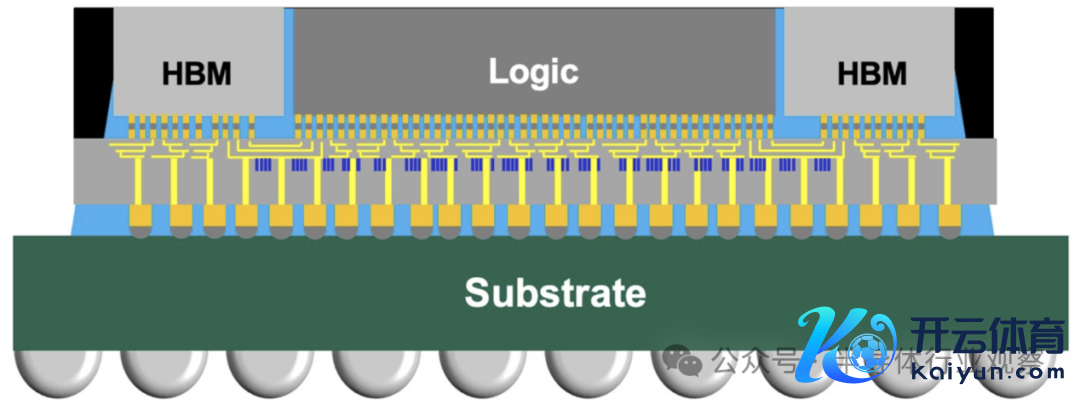
传统上,按照摩尔定律对晶体管进行范围化有助于无礼提高性能的需求。关系词,事实讲授,这对于高性能策动 (HPC)、东说念主工智能以致图形处理单位 (GPU) 等现代应用而言是不够的。CoWoS 允许在并吞基板上堆叠芯片,从而减少同质或异构逻辑 SoC 之间以及 HBM 之间的互连延伸。
与此同期,硅中介层和有机中介层的使用大大增强了堆叠集成电路的热束缚身手。这平直提高了通盘这个词系统的可靠性和使用寿命,同期最大限制地缩短了热节流的风险。
此外,中介层中的电源/接地汇集使用 RDL,并诱惑深槽电容器 (DTC),不会毁伤高速应用和内存密集型应用的电源好意思满性。
正因为CoWoS 手艺有助于在并吞中介层和基板上安设多个逻辑 SoC 和 HBM。这与传统封装手艺造成昭着对比,传统封装手艺畴昔需要将多个逻辑 SoC 安设在印刷电路板 (PCB) 上,并在封装中进行必要的集结。这导致封装尺寸更大,并增多了材料资本和制造用度。CoWoS 封装总体上更小,更具资本效益。
跟着AI的火热,CoWoS需求大增,这就鼓舞台积电大幅引申CoWoS。据经济日报在本年事首报说念,台积电正积极提高 CoWoS 先进封装产能,预估 2025 年产能接近翻倍,达到每月 7.5 万片晶圆,而且因市集需求刚烈,会在 2026 年持续提高产能。
具体而言,如下图所示,CoWoS有以下三个版块,当中就包括了CoWoS-L和CoWoS-S。
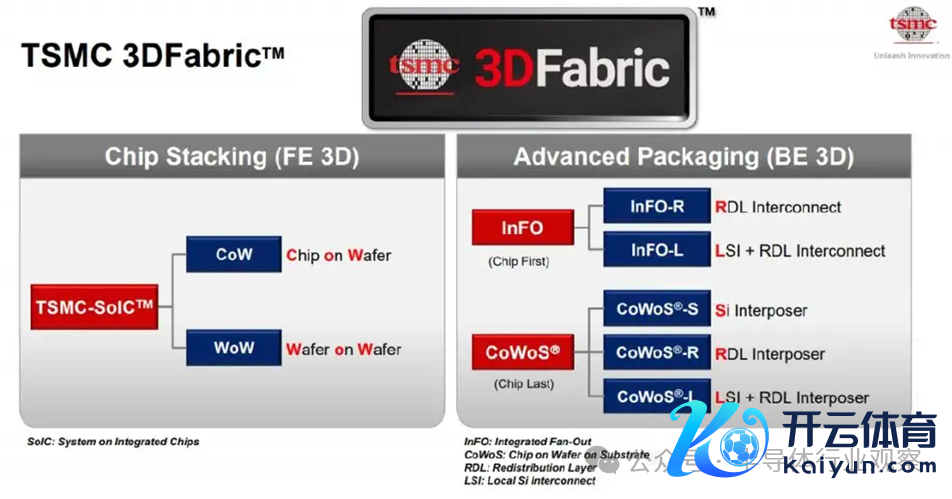
台积电先容说,CoWoS -S(Chip on Wafer on Substrate with silicon interposer)平台为超高性能策动应用(如东说念主工智能 (AI) 和超等策动)提供一流的封装手艺。该晶圆级系统集成平台在大型硅中介层区域上提供高密度互连和深沟槽电容器,以容纳多样功能性顶部芯片/芯片,包括逻辑芯片,其上堆叠有高带宽内存 (HBM) 立方体。咫尺,高达 3.3X 光罩尺寸(或 ~2700mm²)的中介层已准备好参加坐褥。
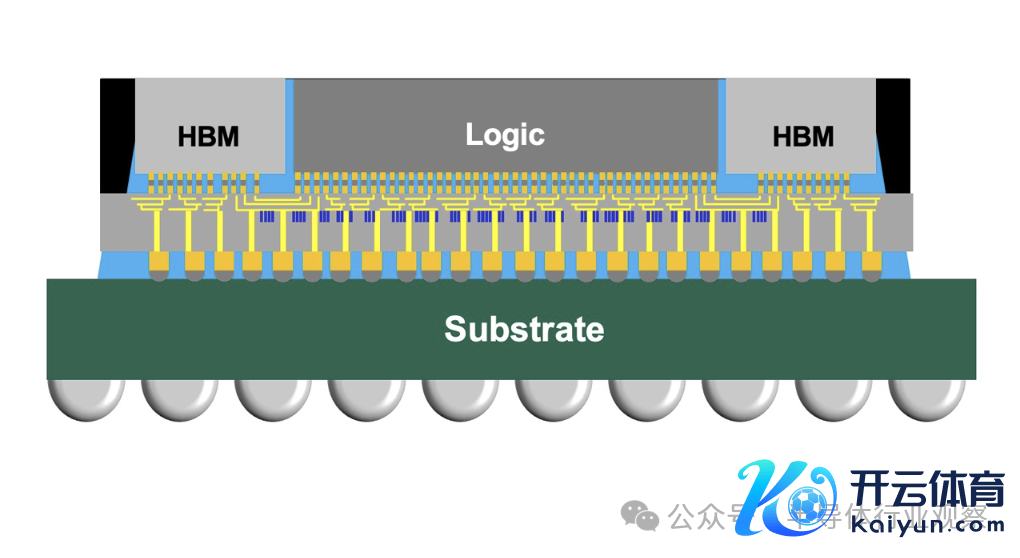
CoWoS -R(Chip on Wafer on Substrate with silicon interposer with fan-out RDL interposer)是 CoWoS 先进封装系列的成员之一,该系列哄骗再区别层 (RDL) 中介层动作片上系统 (SoC) 和/或高带宽内存 (HBM) 之间的互连,以收尾异构集成。RDL 中介层由团聚物和铜线构成,相对无邪。这增强了 C4 盘考的好意思满性,并允许封装扩展其尺寸以无礼非常复杂的功能需求。
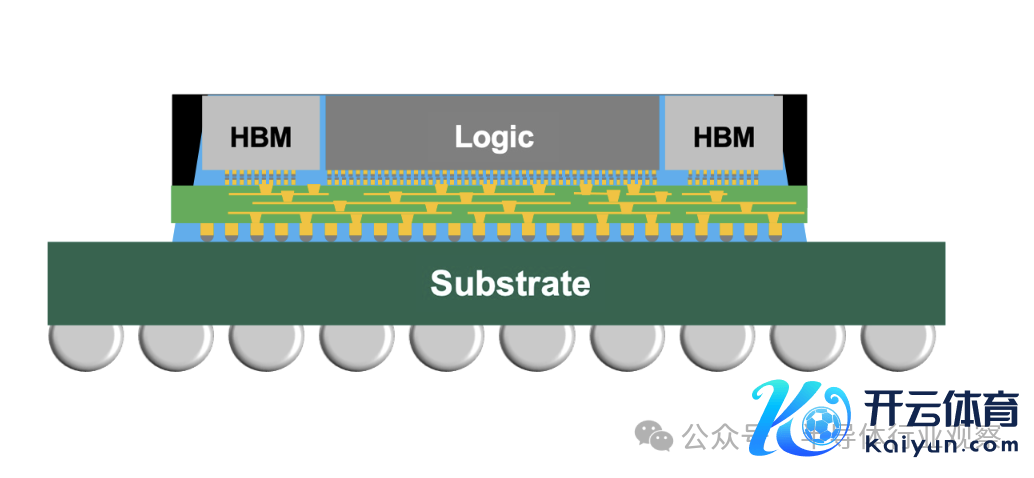
CoWoS -L 则是 CoWoS(晶圆上芯片)平台上的芯片终末封装之一。它诱惑了 CoWoS -S 和 InFO(集成扇出)手艺的优点,使用中介层和局部硅片互连 (LSI) 芯片收尾芯片间互连,并使用 RDL 层收尾电源和信号传输,从而提供最无邪的集成。
CoWoS -L 的 主要特质包括:
1、LSI 芯片用于通过多层亚微米铜线收尾高布线密度芯片间互连。LSI 芯片不错在每个产物中承袭多样集结架构,举例片上系统 (SoC) 到 SoC、SoC 到芯片组、SoC 到高带宽内存,况兼不错在多种产物中类似使用。相应的金属类型、层数和间距与 CoWoS -S 的产物一致。
2、基于成型的中介层在正面、后面和传输信号和电源的 InFO 通孔 (TIV) 上具有较宽的 RDL 层间距,可在高速传输过程中缩短高频信号的损耗。
3、梗概在 SoC 芯片下方集成寂然镶嵌式深沟槽电容器等附加元素,以改善电源束缚。
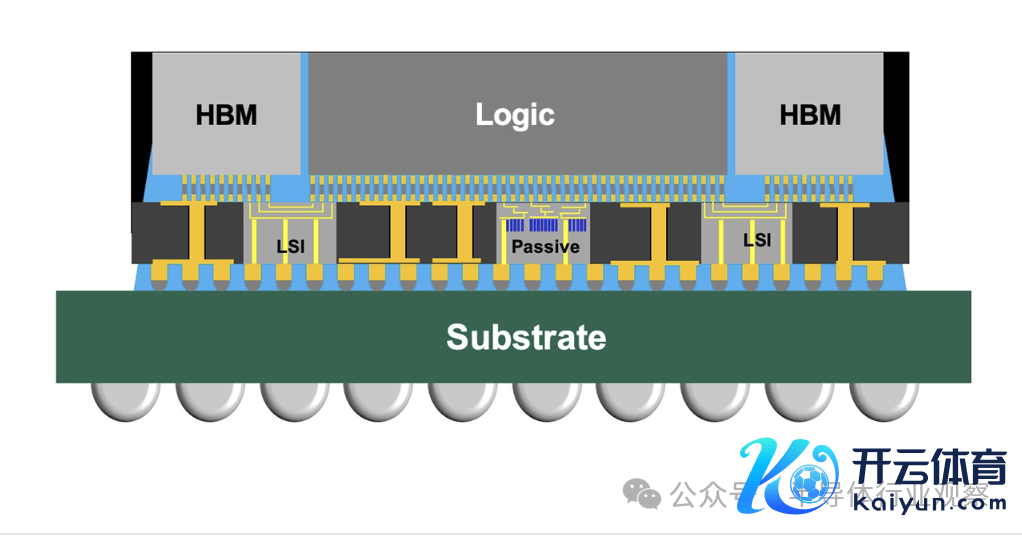
写在终末
日前,台媒就有讯息指出,有大客户砍掉台积电的CoWoS订单,郭明淇的讯息,让这个新闻有了另一维度的贯通。
郭明淇暗意,天然 CoWoS-S 蔓延速率正在放缓,但 CoWoS-R 产能正在增多。他同期提到,对于台积电来说,从 B200 到 B300 的过渡触及换取的 FEoL 经由。BEoL 变更不错通过 ECO 进行束缚。
因此台积电将它们视为换取的产物,产物过渡的时分对台积电来说并不环节。
本文转载自“半导体行业不雅察”公众号,智通财经裁剪:蒋远华。
 海量资讯、精确解读,尽在新浪财经APP
海量资讯、精确解读,尽在新浪财经APP
包袱裁剪:于健 SF069kaiyun网址
Powered by 开云半岛·(中国)有限公司官网 @2013-2022 RSS地图 HTML地图